CSP(晶片尺寸封裝) vs. WLCSP(晶圓級晶片尺寸封裝)



WLCSP : Die size / Package size = 90 – 100 %

Mold Type : Die size / Package size = 20 – 30 %
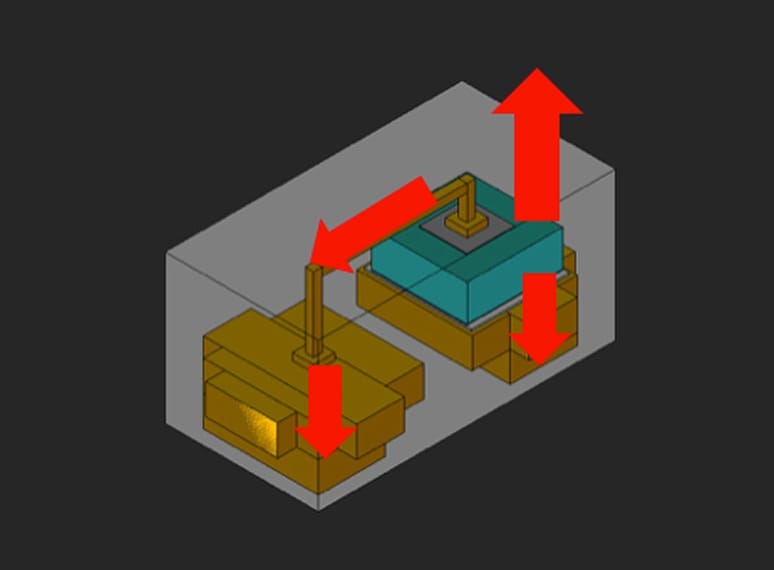
熱傳遞主要有三條路徑:
1. 晶片表面的熱源透過模封樹脂,以對流與輻射方式傳遞至元件表面。
2. 熱量由晶片表面經由鍵合線傳遞,再透過焊墊(Bonding Pad)傳導至 PCB 板,並以對流與輻射方式散熱。
3. 熱量由晶片表面傳至晶座(Die Pad),再經由焊接焊墊傳導至 PCB 板,並以對流與輻射方式散熱。
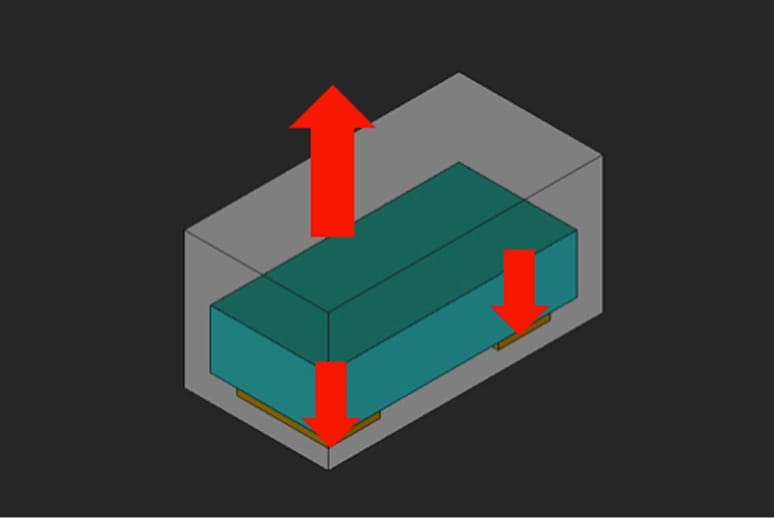
熱傳遞主要有兩條路徑:
1. 晶片表面的熱源透過模封材料,以對流與輻射方式傳遞至元件表面。
2. 熱量由晶片表面經由銅柱(Copper Pillar)傳遞,再透過焊墊(Solder Pad)導入 PCB 板,並以對流與輻射方式散熱。

<0201 Mold Type> 𝜃JA = 227.6 K/W ; 𝜃JB = 123.76 K/W ; 𝜃JC = 122.91 K/W

<0201 WLCSP> 𝜃JA = 135.48 K/W ; 𝜃JB = 31.81 K/W ; 𝜃JC = 65.53 K/W ; Mold R𝜃J / WLCSP R𝜃J = 45 - 65% ; Mold TJMax < WLCSP TJMaX
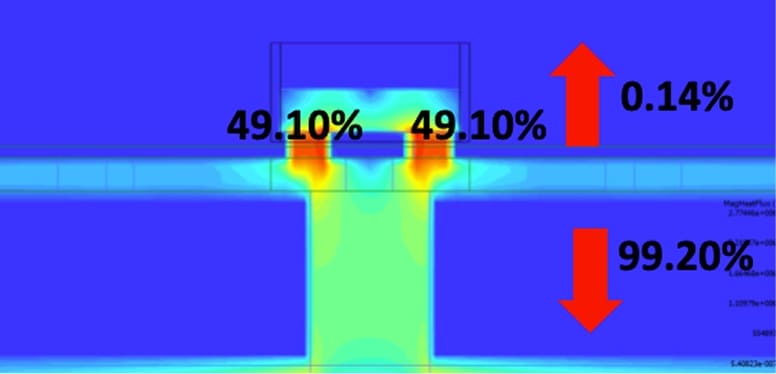
<01005 WLCSP (0.2mm)> 𝜃JA = 165.68 K/W ; 𝜃JB = 64.88 K/W ; 𝜃JC = 118.27 K/W

<01005 WLCSP (0.15mm)> 𝜃JA = 165.69 K/W ; 𝜃JB = 63.82 K/W ; 𝜃JC = 77.61 K/W ; Thick R𝜃J > Thin R𝜃J ; Thick TJMax ≈ Thin TJMax
蕭特基二極體(Schottky):
I/O = 100 mA,VF = 0.538 V
θJA:晶片表面至周圍環境的熱阻
θJB:晶片表面至電路板的熱阻
θJC:晶片表面至封裝外殼的熱阻

寄生元件:
晶片對晶片(Die to Die) → 金線(Au Wire)
晶片對基板(Die to Substrate) → 銀膠(Silver Paste)
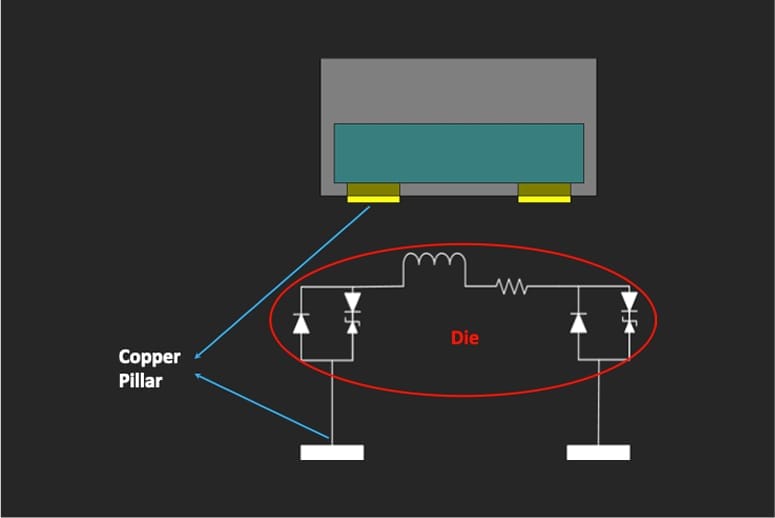
寄生元件:
無導線(No Wire)
無基板(No Substrate)
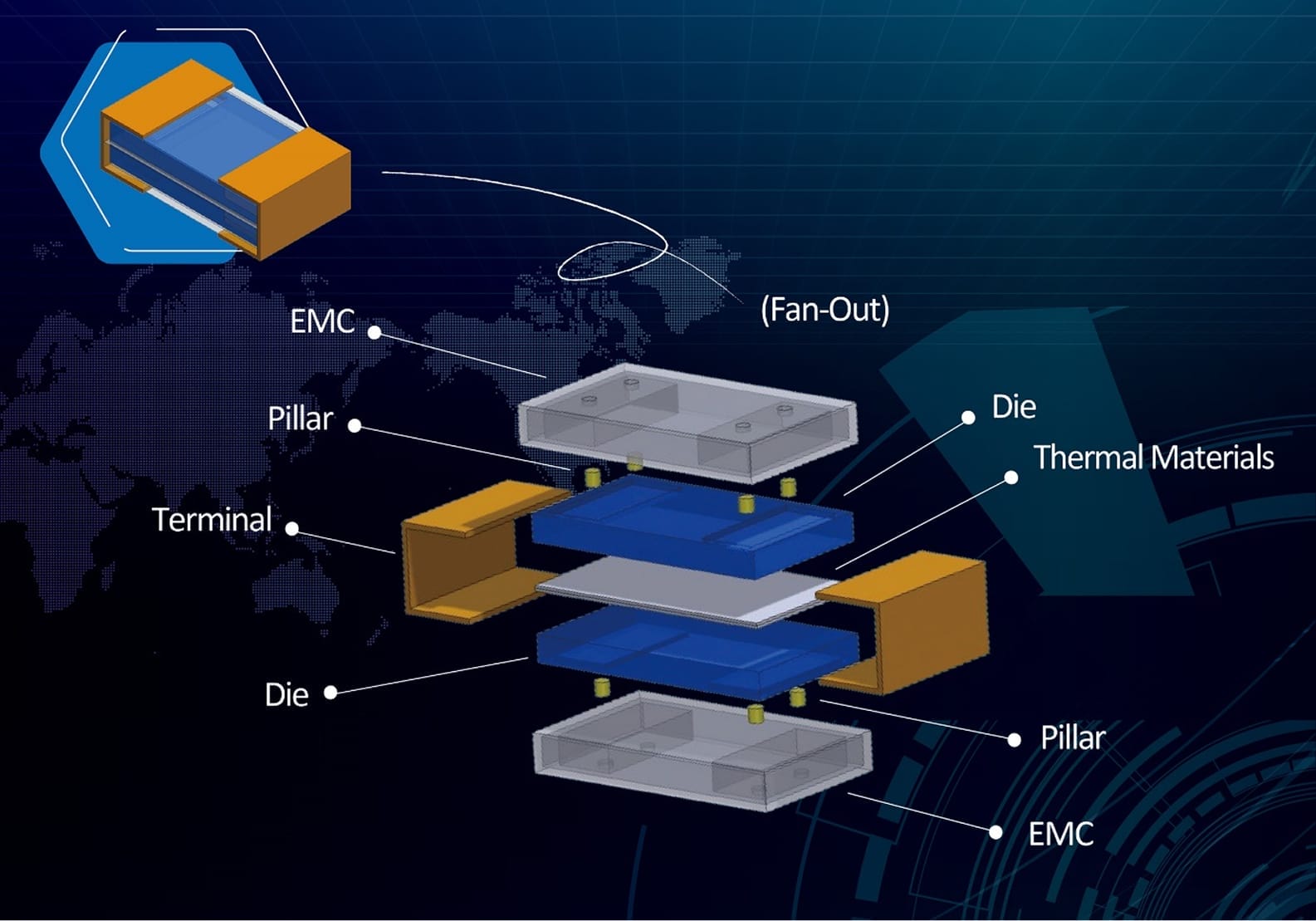
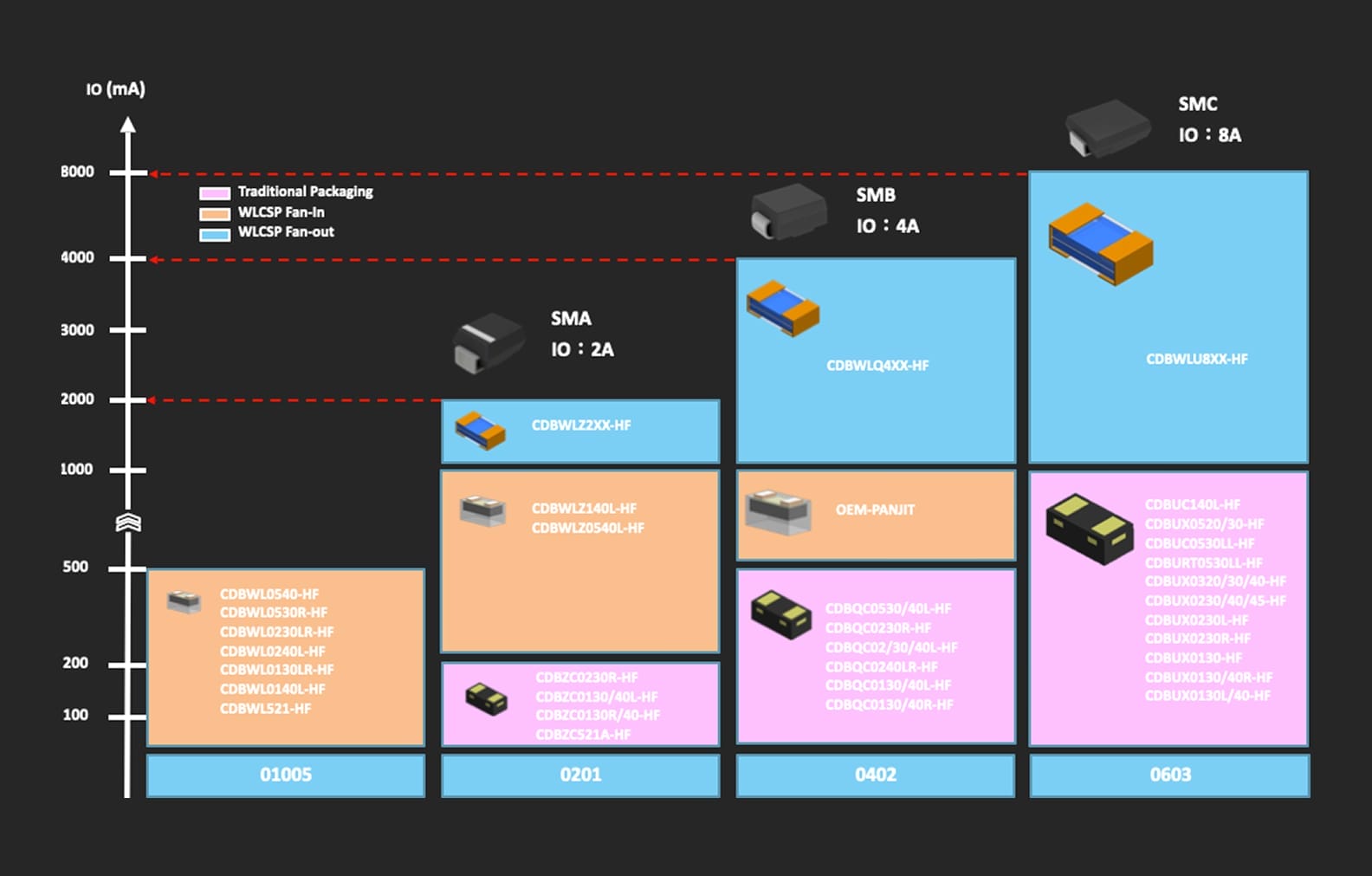
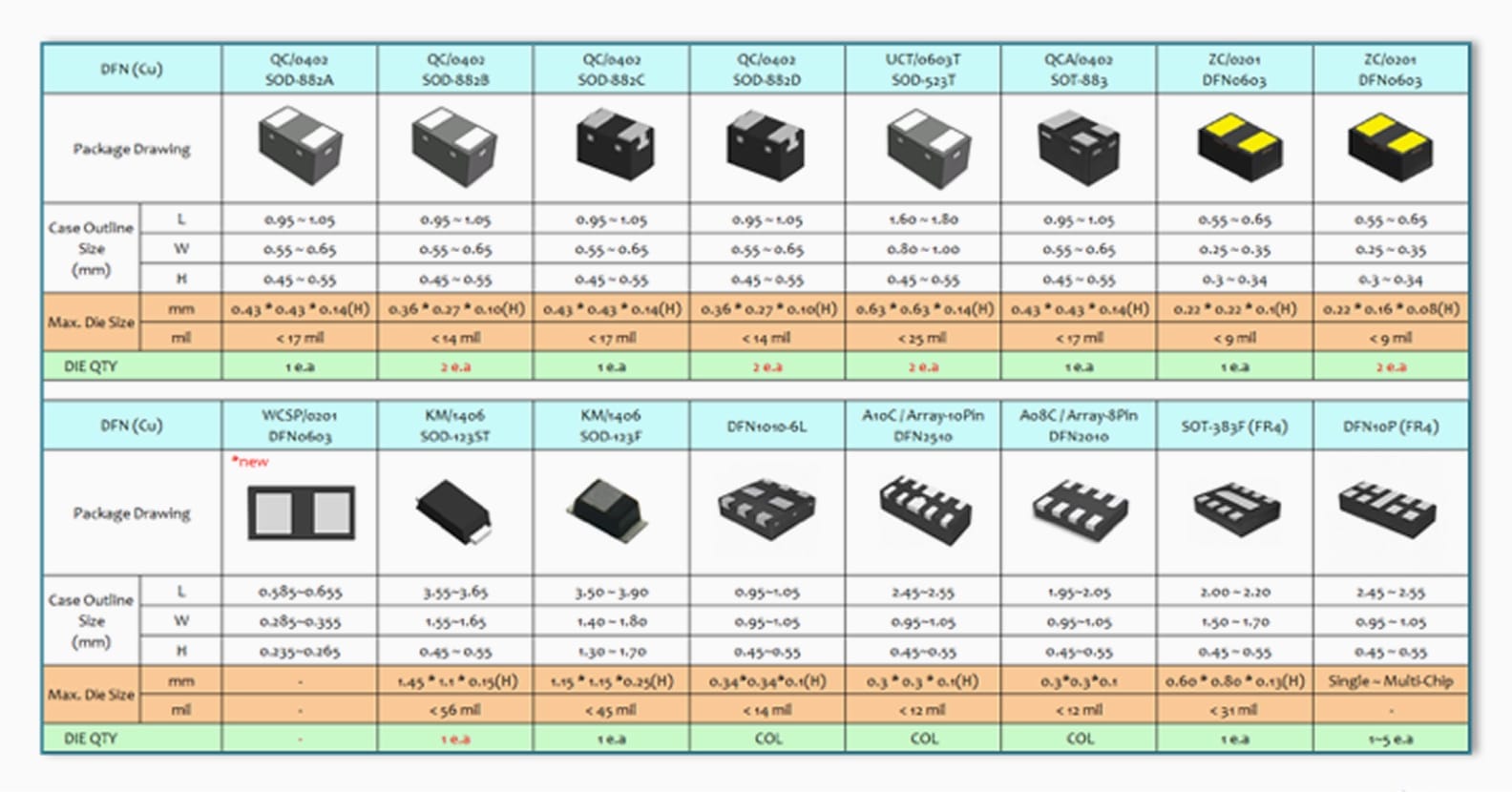
DFN 產品於 典琦科技 台灣製造基地生產。

典琦科技 的 0402、0603 與 1005 封裝皆採用特殊的側邊可潤濕設計,以提升焊接性。

歡迎您來到「典琦科技」(以下簡稱「本網站」)。
為了確保您能夠安心使用本網站提供的服務和信息,我們特此解釋我們的隱私政策,以保護您的權利和利益。請仔細閱讀以下內容: